苹果被曝加速采用台积电SoIC封装技术 预期2025年投入应用
7月4日,据报道,继 AMD 之后,苹果公司扩大了与台积电在 SoIC(System on Integrated Chips)封装方案上的合作,并计划在2025年采用这一技术。此举将推动台积电下一代封装方案的产业化进程。
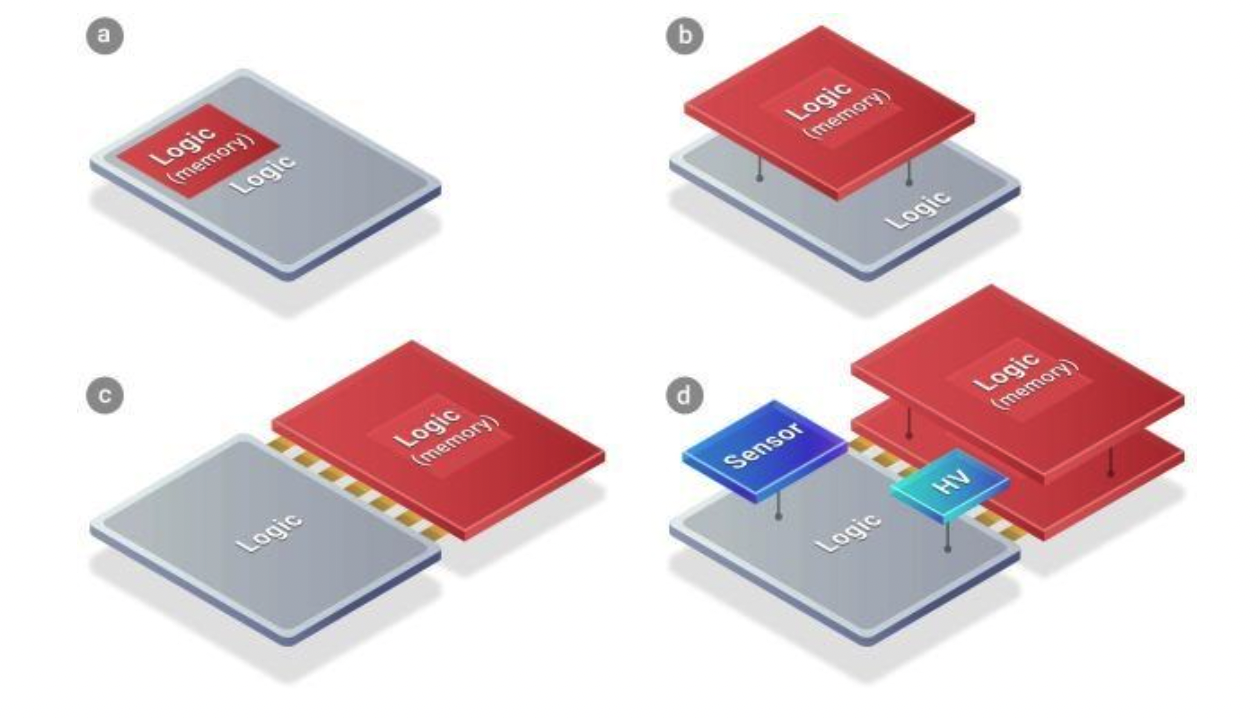
台积电目前在提升 CoWoS(Chip on Wafer on Substrate)封装产能的同时,积极推动 SoIC 封装技术的应用:CoWoS:一种2.5D集成生产技术。该技术将芯片通过 Chip on Wafer(CoW)封装到硅晶圆上,再与基板(Substrate)连接,形成集成的CoWoS系统。这种技术可有效集成多芯片,提升性能与效率。SoIC:台积电于2018年推出的3D堆叠封装技术,整合了 CoWoS 和多晶圆堆叠 (WoW) 封装技术。SoIC标志着台积电具备直接为客户生产3D IC的能力,可实现不同尺寸、功能、节点晶粒的异质整合。
苹果对 SoIC 封装方案表现出浓厚兴趣,并计划将其与 Hybrid molding(热塑碳纤板复合成型技术)结合,初期应用于 Mac 产品线。目前,苹果已进入小规模试产阶段,预计2025年至2026年量产。这将显著提升苹果设备的性能和集成度,同时加速其在半导体封装技术上的创新步伐。
AMD 是台积电 SoIC 封装的首发客户,其 MI300 加速卡使用了 SoIC+CoWoS 方案。这款加速卡已在台积电竹南的第五座封测厂 AP6 量产。这种封装方案允许不同功能和尺寸的芯片通过3D堆叠技术集成,提供更高的性能和效率。
目前,台积电的 CoWoS 系列产能紧张,正通过扩建自家工厂和与其他封测厂合作来提高产能。然而,SoIC 封装目前没有遇到明显的产能瓶颈,自2022年起已开始小规模投产,计划到2026年将产能扩大20倍以上。